
図1 CZシリコン単結晶成長の概略図

図2 MCZ法の概略図
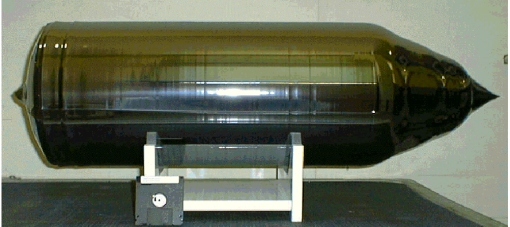
図3 HMCZ法により成長した300 mmφシリコン単結晶。重さ約140kg。
図1に示されるように、CZ法によるシリコン単結晶の成長は、石英ルツボに高純度の多結晶シリコンを熔解し、種結晶をその融液に接触させた後、上方に引き上げる。大直径のシリコン単結晶の成長には、結晶直径の2〜3倍の直径をもつ石英ルツボを使用し、多量の多結晶原料が熔解される。その為、単結晶が大直径化する程、融液量が増し、融液対流が強くなる。その結果、融液温度の不安定性を招き、単結晶化が難しくなるという問題があるという。また、石英ルツボの大型化により、ルツボの温度が上昇し、その溶解速度が増す。その結果、単結晶中に取り込まれる酸素濃度が増加するという問題もあって、融液対流の制御は、大直径シリコン単結晶の成長における重要な課題のひとつである。
融液対流の制御を目的として、融液に磁場を印加するMCZ (Magnetic field applied CZ)法が考案されている。磁場印加方法としては、三相交流加熱による電導性融液の誘電回転効果を利用した方法と、単結晶引上げ装置の周囲に磁場発生装置を配置し静磁場を印加する方法があるが、後者の方法が主に利用されてきている。静磁場を印加する方法として、代表的には以下の3種類が提案されている(図2)。
a) HMCZ(横磁場型、Horizontal MCZ):電磁石のコイルを単結晶引上げ機の左右に設置し、シリコン融液に対して水平方向の磁場を印加する。
b) VMCZ (縦磁場型、Vertical MCZ):ソレノイドコイルを単結晶引上げ機の周囲に配置し、シリコン融液に対して鉛直方向の磁場を印加する。
c) カスプMCZ (Cusp MCZ):単結晶引上げ機を囲む上下一対の電磁コイルに、上下逆方向に電流を流すことで、放射状の不均一な磁場を印加する。現在は、主にHMCZやカスプMCZが工業的に利用されている。
磁場発生装置としては、常電導と超電導の電磁石が利用されている。MCZ法によるシリコン単結晶の成長においては、融液近傍で数百〜数千ガウスの磁場強度が必要とされ、大直径結晶を成長させる大型引上げ機の場合、電磁石と融液の距離が大きくなる為、より強力な電磁石が必要となる。従って、大直径結晶の成長の場合、より低コストで強磁場の発生可能な超電導磁石が有利となってきている。ただし、単結晶引上げ機は1台ずつ隔離されることなく、工場内に並べて配置されるので、超電導磁石を利用した場合、漏洩磁場が大きな問題のひとつとなっている。
シリコン融液に磁場を印加した場合の融液対流への影響については様々な報告があるが、基本的には磁場の印加により融液対流は抑制されることがわかっている。結晶の品質に与える影響については、融液対流の抑制により結晶中に取り込まれる不純物分布等は均一化されるが、デバイスの製造に関わるような品質はCZ法による結晶とほぼ同等であるという。
大直径結晶への応用例として、信越半導体では、実際に超電導磁石を用いたHMCZ法で300 mmφシリコン単結晶の成長を行っている(図3)。
開発担当者のひとりである信越半導体磯部研究所の飯野氏は「300 mmφ結晶の成長には磁場印加の効果がはっきりと現れてきています。将来的にも大直径Si単結晶の成長には磁場印加が不可欠でしょう。」と述べている。
(マジンガーCZ)


図2 MCZ法の概略図
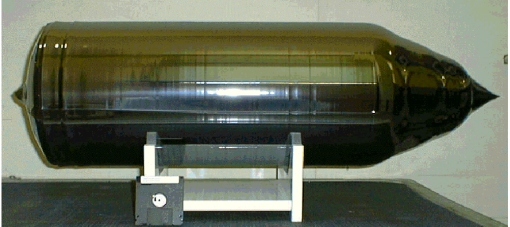
図3 HMCZ法により成長した300 mmφシリコン単結晶。重さ約140kg。